IC Substrate-Globalny niedobór układów scalonych w latach 2020-2022 przypomniał nam, jak ważne są układy scalone. Umożliwiają one masową produkcję nowoczesnych produktów elektronicznych. Ważną cechą obecnych układów scalonych jest ich opakowanie. Podobnie jak płytki drukowane, do których są przymocowane, wymagają one specjalistycznego podłoża. Musimy więc zrozumieć, dlaczego podłoże jest istotną częścią struktury układu scalonego. W związku z tym, w tym przewodniku omówiono podłoże układu scalonego, sposób jego produkcji i zastosowania oraz technologię produkcji związaną z jego tworzeniem. Pod koniec tego przewodnika dowiesz się wszystkiego, co musisz wiedzieć o podłożach układów scalonych.
Co to jest podłoże IC?

Pracownik trzymający układ scalony
Podłoże układu scalonego (lub podłoże pakietu IC) jest podstawowym materiałem pakietów IC. Oprócz ochrony gołego układu scalonego, ułatwiają one również połączenia pomiędzy układem scalonym a siecią ścieżek na płytce PCB. Jako takie, podłoże w dużym stopniu wpływa na wydajność układu.
Składają się one z kilku warstw i rdzenia nośnego w środku. Ponadto, podłoże układu scalonego zawiera sieć otworów i podkładek pod przewodniki. Często przekraczają one gęstość konwencjonalnych płytek PCB. Dlatego mogą być dość skomplikowane w produkcji.
Klasyfikacje podłoży IC

Płytka krzemowa do budowy podłoży do układów scalonych
Podłoża IC są zróżnicowane i podlegają trzem głównym klasyfikacjom. Klasyfikacje te obejmują typ pakietu/opakowania, technologię klejenia oraz atrybuty/charakterystyki materiału. Dodatkowo, możemy je podzielić na obszary zastosowań.
Według typów opakowań

Układ scalony na niebieskiej płytce drukowanej
Typ opakowania opisuje rodzaj nośnika. W związku z tym każdy pakiet może wymagać innej odmiany podłoży.
Podłoże Ball Grid Array IC: ten rodzaj podłoża jest odpowiedni dla pakietów IC z dużą liczbą pinów (>300). Wewnętrznie, możemy przypisać to do jego doskonałej wydajności elektrycznej i rozpraszania ciepła.
Chip-scale pakiet IC substrat: ten typ podłoża jest zminiaturyzowany i cienki. Dzięki temu nadaje się do mniejszych pakietów jednoukładowych o małej liczbie pinów (CSP).
Podłoże IC typu flip-chip: ten typ podłoża jest najbardziej odpowiedni dla kontrolowanych połączeń chipowych w pakiecie flip-chip chip-scale (FCCSP). Dzięki temu ma dobrą ochronę przed utratą obwodu i zakłóceniami sygnałów przez rozpraszanie ciepła.
Podłoże IC modułu wielochipowego: Podłoża w tego typu opakowaniach mieszczą wiele układów scalonych. Każdy IC może mieć inną funkcję. W związku z tym podłoże musi być lekkie. Jednak ze względu na naturę układów scalonych MCM, podłoże to może nie być odporne na zakłócenia sygnału, dobre trasowanie lub dobre odprowadzanie ciepła.

Układ scalony z siatką lutowanych kulek
IC Substrate-Przez technologię łączenia
Technologia łączenia opisuje sposób, w jaki układ scalony łączy się z pakietem lub zewnętrznymi obwodami. Ponownie, każde połączenie może wymagać podłoża o unikalnych właściwościach.
Łączenie drutem: Jest to najczęstszy rodzaj klejenia. Zazwyczaj operator lub maszyna przewleka przewody od połączeń na układzie scalonym do pakietu/nośnika lub obwodu zewnętrznego.
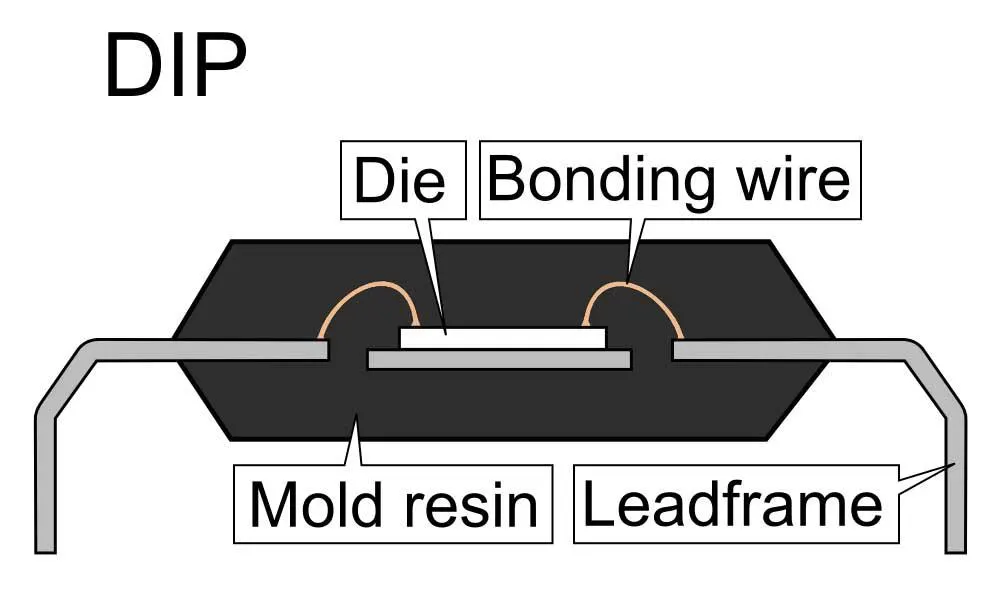
Klejenie drutem zilustrowane w pakiecie DIP
Tape automated bonding (TAB): Opisuje produkcję elastycznych obwodów drukowanych (FPC), w których producent łączy obwody zintegrowane z wysokowydajnymi przewodnikami w bazie polimerowej

Zdjęcie układu wstecznego (IC) na płycie pasywnej
IC Substrate-Według właściwości materiału
Ze względu na różne możliwości układów scalonych, ich podłoże będzie wymagało różnych typów materiałów i właściwości Najczęściej występują
Sztywność, sztywność Producenci używają żywicy do tworzenia tych rodzajów płyt Dlatego mogą składać się z membrany amorficznej Ajinomoto (ABF), żywicy epoksydowej lub materiału bismaleimidowego (BT)
elastyczność, która pozwala Używamy poliamidu lub poliamidu do tworzenia tego typu płyt Wszystkie mają podobną wydajność elektryczną i współczynnik rozszerzalności cieplnej
Kategoria: Ceramika Wykorzystujemy ceramikę do tworzenia tego typu płyt Zwykle składa się z azotku aluminium, węglika krzemu lub tlenku glinu
Zastosowanie płyty PCB układu scalonego

Zainstaluj obwód zintegrowany w module pamięci RAM
Możemy użyć płyt IC
Zestawienie chipów pamięci masowej
Uszczelnienie systemów mikroelektrycznych (MEMS)
Zestawienie chipów RF
Uszczelnienie chipa procesora
Uszczelnianie układów scalonych w urządzeniach komunikacyjnych o dużej prędkości
Możemy znaleźć te chipy i ich opakowania w praktycznych zastosowaniach (zintegrowane płyty obwodów umożliwiają to), na przykład
Inteligentne rozwiązania mobilne, takie jak smartfony i tablety
Notebooki, drukarki i produkty pamięci (takie jak moduły pamięci RAM)
Kategoria: Przygotowania medyczne
-Telekomunikacja
Kategoria: Lotnictwo i sprawy wojskowe
Roboty przemysłowe
IC Substrate-Specyfikacja płyty zintegrowanej obwodu
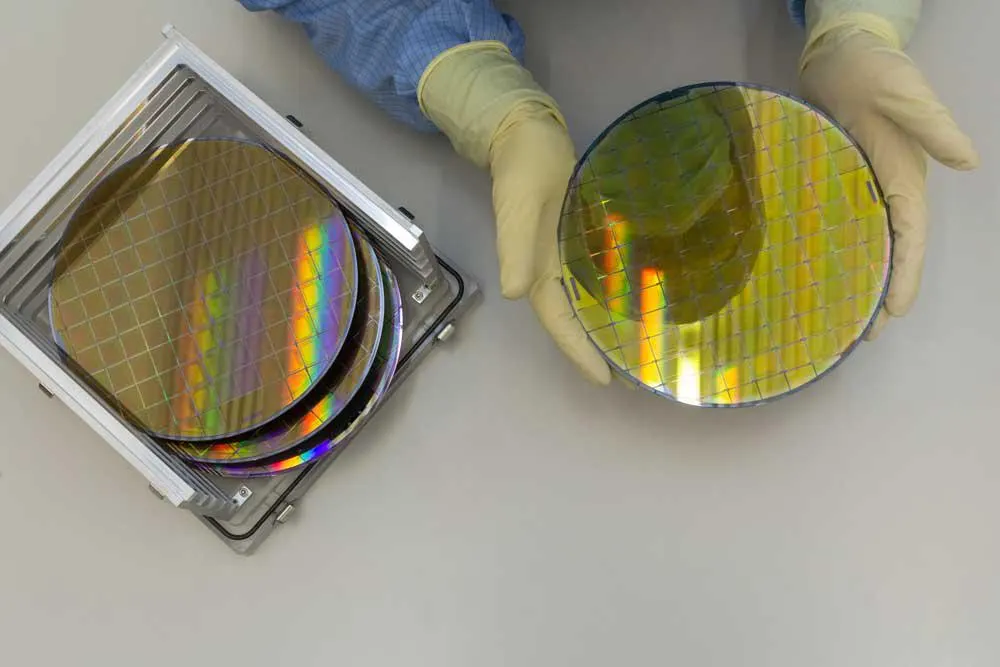
Jeden z robotników trzymał płytkę krzemową
Podłoże obwodu zintegrowanego ma wiele atrybutów i cech Niektóre z nich to między innymi
Kategoria: Lekkie grubości Płyty zintegrowane są zwykle bardzo lekkie Głównie dlatego, że używają materiałów
Niezwykle niezawodne Te podłoże tworzą otulinę wokół obwodu zintegrowanego Dlatego muszą składać się z materiałów stałych
Wymaga mniejszej liczby przewodów i połączeń lutowanych Płyty IC są zwykle mniejsze niż typowe płyty PCB Dlatego wymagają mniejszej liczby przewodów i połączeń lutowanych
Niewielka liczba osób Zintegrowane płyty podłogowe zostały zaprojektowane z myślą o małej konstrukcji Więc potrzebują mniej materiałów do budowy rekwizytów
Wytrzymałość i wytrzymałość Pomimo małych rozmiarów, płyty IC są solidne
IC Substrate-Technologia produkcji zintegrowanych płyt podłogowych
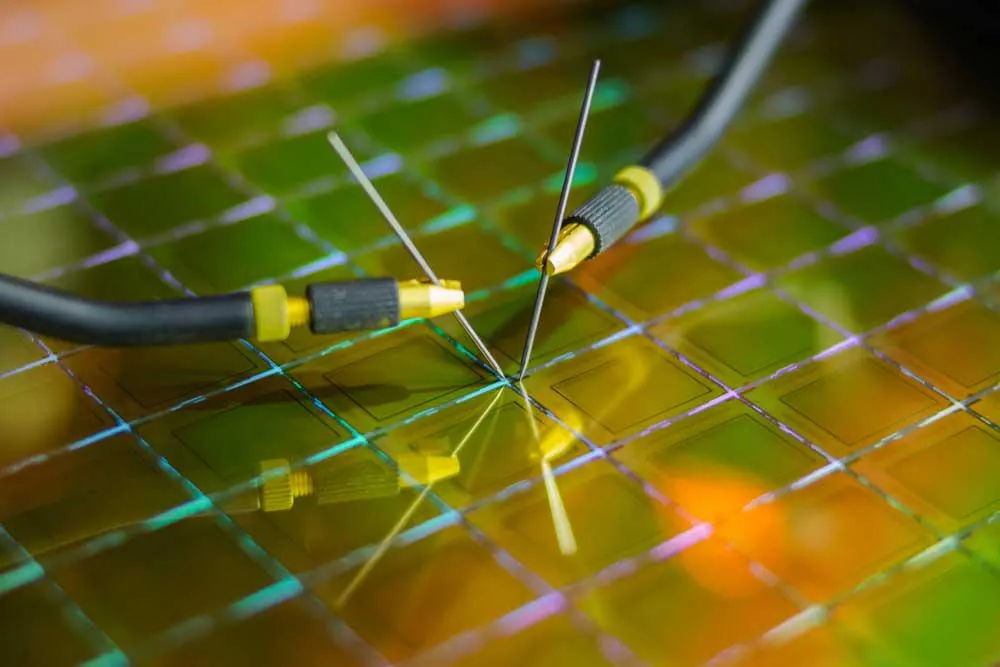
które wykrywają mikrochipy na krzemowych chipach
Istnieją trzy rodzaje metod produkcji płyt IC Są to między innymi liczby osób
Subtraktion (SP) to najczęściej stosowana metoda produkcji IC i PCB Obejmuje to pierwsze zastosowanie warstwy miedzianej do laminatów miedzianych Następnie producenci płyt używają powłoki suchej membrany, aby chronić obwód i otwór przejściowy Na koniec producenci wytrawią wszystkie niepotrzebne brązowe talerze
Dodaj metodę (AP) Producenci będą stosować podłoże izolacyjne do odsłoniętych obwodów Przy okazji, izolacja będzie zawierać katalizatory fotoczułe Następnie producenci selektywnie odkładają chemiczne miedziane związki na boisku
Ulepszony proces półdodawania (MSAP) Ta metoda powoduje anodyzowanie cienkiej warstwy miedzi na głównej płycie laminowanej Następnie producent przyłoży otulinę do obszarów, które są niemożliwe lub niepotrzebne do anodyzowania laminatów Następnie producent galwanizuje płytę i nakłada na nią warstwę balsamowanych substancji chemicznych Następnie producent uszlachetnia podłoże, usuwając nadmiar miedzi w procesie trawienia błyskowego.
IC Substrate-Proces produkcji podłoża do układów scalonych

Operatorzy przy linii produkcyjnej w zakładzie produkcyjnym
Wzornictwo i galwanizacja miedzi: Polega na przygotowaniu materiału miedzianego poprzez manipulację i kształtowanie go. W związku z tym, technika ta wymaga maszyn, które dostosowują grubość i kształt miedzi. W związku z tym jest to pierwszy krok w procesie produkcyjnym.
Solder Mask: Polega to na nałożeniu maski lutowniczej na podłoże. Producent podłoża użyje kombinacji technologii drukowania maski lutowniczej i sprzętu do wypełniania otworów przelotowych.
Wykończenie powierzchni: Ten proces obejmuje polerowanie i polerowanie podłoża, aby zapewnić, że ma ono jednolitą i równą powierzchnię.
Inspekcja: Producent musi przetestować końcowe podłoże pod kątem integralności i niezawodności podczas tego procesu.
Trudności produkcyjne związane z substratami IC
Ponieważ proces produkcji substratów IC może być dość skomplikowany, wiąże się z wieloma wyzwaniami. W związku z tym, niektóre z tych trudności obejmują:
IC Substrate-Produkcja substratów IC

Obraz z bliska cięcia CNC LPG
Ze względu na rozmiar i konsystencję substratów IC, mogą one być dość kruche i łatwe do zniekształcenia. Ponadto, fakt ten jest szczególnie aktualny w przypadku podłoży o szerokości mniejszej niż 0,2 mm. Możemy kontrolować i zapobiegać deformacjom podłoża poprzez zapewnienie lepszych parametrów laminacji i pozycjonowania warstw. Ponadto, musimy zwrócić szczególną uwagę na proces kurczenia się płyty, aby uzyskać maksymalną wydajność.
IC Substrate-Technologia wytwarzania w technologii Microvia
Technologia ta polega na zastosowaniu laserowo wierconych i galwanizowanych otworów przelotowych, masek konformalnych oraz wypełnienia miedzianą płytką. Ponownie, zastosowanie tej technologii może być trudne ze względu na miniaturową skalę większości układów scalonych i ich podłoży. Jednakże, możemy użyć masek ślepych i konformalnych, aby ułatwić wiercenie laserowe.
Wzornictwo i technologia powlekania miedzią
Wzornictwo zewnętrzne może być skomplikowane, zwłaszcza w przypadku mniejszych rozmiarów. Technologia ta obejmuje sprzęt do kontroli i kompensacji obwodów, kontrolę przemysłową dla jednolitej grubości powlekania miedzią oraz produkcję cienkich drutów. Technologie te są również zaangażowane w łączenie.
IC Substrate-Maska lutownicza

Podłoże z połączeniami lutowniczymi i maskami lutowniczymi
Tworzenie maski lutowniczej jest niezbędne w procesie produkcji podłoży do układów scalonych. W związku z tym, powierzchnia podłoża IC zazwyczaj nie przekracza 10um. Ponadto, różnica wielkości pomiędzy maską lutowniczą a padem nie może być większa niż 15 mikronów. Tak więc, zastosowanie maski lutowniczej dla podłoży IC wymaga większej staranności niż PCB. W związku z tym, musimy używać specjalistycznej technologii, sprzętu i procedur do drukowania maski lutowniczej i wypełniania otworów przelotowych.
IC Substrate-Wykończenie powierzchni

Pracownik sprawdzający płytkę z układem scalonym w fabryce
Wykończenie powierzchni obejmuje polerowanie i wygładzanie podłoża układu scalonego. Może nie jest to tak skomplikowane jak inne etapy procesu produkcyjnego, ale nadal wymaga szczególnej uwagi. W związku z tym, musimy skupić się na zapewnieniu, że powierzchnia podłoża układu scalonego jest jednolita. Zazwyczaj producenci stosują do wykończenia powierzchni złoto bezprądowo niklowe (ENIG) lub złoto bezprądowo palladowe (ENEPIG).
Możliwości kontroli i technologia testowania niezawodności produktu

Próbka testowa zminiaturyzowanego układu scalonego pod mikroskopem
Końcowa faza procesu produkcyjnego. W szczególności, producenci wymagają różnych technik i technologii kontroli, aby przetestować i zapewnić kompletność całego podłoża układu scalonego. Ponadto wymaga doświadczonych operatorów i techników znających te techniki i technologie.
IC Substrate-Skład opakowań układów scalonych i ich koszt

Pracownik przechadza się po podłodze zakładu produkcji wafli Intela.
Podłoże jest głównym składnikiem opakowania. Dlatego, w zależności od materiału, z którego jest wykonany, jest to najdroższy aspekt. Ponownie, podłoże może być sztywne (twarde), miękkie/elastyczne lub ceramiczne. Podłoża ceramiczne mają tendencję do dłuższego czasu produkcji. Z kolei produkcja podłoży elastycznych i sztywnych zajmuje zwykle podobną ilość czasu.
Kolejnym krytycznym aspektem opakowania IC jest ultracienka folia z miedzi elektrolitycznej. Podłoże IC wymaga, aby była ona całkowicie jednolita o gęstości 1,5μm. Nawiasem mówiąc, cena ultracienkiej folii miedzi elektrolitycznej jest większa niż jej zwykłego odpowiednika.
Podsumowanie
Powyższy przewodnik bada wszystkie aspekty podłoży do układów scalonych. Mają one wiele podobieństw do podłoży PCB. Są one jednak bardziej wyspecjalizowane ze względu na swoje rozmiary. Dodatkowo, podłoża IC i ich materiały są nieco bardziej zróżnicowane.
Niemniej jednak, produkcja podłoży IC i PCB wymaga doświadczonego producenta. Przykładowo, lider branży może pozyskiwać najlepsze materiały i wykorzystywać najnowsze technologie do produkcji wysokiej jakości płytek drukowanych. Od walidacji projektu Gerber do dokładnej kontroli gotowego produktu, OurPCB jest oczywistym wyborem dla wysokiej wydajności produkcji. Niezależnie od tego, mamy nadzieję, że ten przewodnik okazał się pomocny. Dziękujemy za przeczytanie.
